Инспекционный микроскоп Nikon Eclipse L200
- Производитель:
- 1
- Тип микроскопа:Прямой
- Класс микроскопа:Исследовательский
- Область применения:Микроэлектроника, полупроводниковое производство
- Методы исследования:В отраженном(Nikon L200N) и проходящем(L200ND) свете
- Методы получения изображения:Светлое поле/темное поле/поляризация/ДИК-метод и др.
- Класс объективов:Полуапохроматический/ апохроматические
- Диапазон увеличений:х50-х2000
- Вывод изображения:Есть (тринокуляр)
- Освещение:Галогеновый / ксеноновый
- Особенности:Возможность оснащения автоматической системой подачи образцов NWL200, которая позволяет построить полностью автоматизированный комплекс контроля качества.
Инспекционные микроскопы Nikon L200N и L200ND предназначены для изучения и контроля качества интегральных схем и полупроводниковых пластин.
Использование объективов CFI60 идеально подходит для проверки 200-миллиметровых пластин и масок.
В сочетании с превосходной оптической системой Nikon CFI60 LU / L и новой системой освещения этот микроскоп обеспечивает воспроизведение изображений с большей контрастностью, высокой разрешающей способностью и работу в режиме темного поля в три раза ярче, чем было достигнуто ранее. При использовании независимо или в сочетании с загрузчиками пластин серия L200 выполняет исключительно точный оптический контроль пластин, фотошаблонов, сеток и других подложек.
Nikon L200N предназначен для изучения полупроводниковых пластин диаметром до 200 мм при эпископическом освещении, предназначен для проведения исследований в светлом и темном поле, ДИК и поляризованном свете (для работы только в отраженном свете).
Моторизованный 6-ти позиционный револьвер с центровкой объективов; есть возможность подключения моторизированной системы фокусировки, автоматическое управление полевой и апертурной диафрагмами;

Три типа осветителей: галогенный 100 Вт (150 Вт) и ксеноновый 75 Вт;
Специализированный столик с перемещением по XY 205 х 205 мм и набором вставок;
Управление микроскопом вынесено на переднюю панель; имеется возможность подключения дистанционного пульта, что в совокупности с автоматической системой подачи образцов NWL200 позволяет построить полностью автоматизированный комплекс контроля качества.
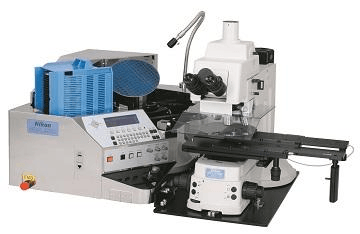
Nikon L200ND предназначен для изучение полупроводниковых пластин диаметром до 200 мм при эпископическом и диаскопическом освещении, проведения исследований в светлом и темном поле, методом ДИК и в поляризованном свете (для работы в отраженном и проходящем свете).
Благодаря разработке новой линейки объективов с использованием линзы Френеля для работы на сверхбольших расстояниях, удалось значительно увеличить рабочее расстояние, при этом парфокальное расстояние стало меньше, размеры и вес объективов также уменьшились.
Многолетний опыт и тесное сотрудничество со специалистами в разных областях промышленности помогли разработать удобную и эргономичную модульную конструкцию микроскопа. Специальное антистатическое покрытие предотвращает попадание инородных частиц на образец.
Механизм управления предметным столом для прецизионного перемещения по осям XY расположен так, что позволяет управлять перемещением стола и фокусировкой микроскопа одной рукой.

Разница между микроскопами L200 и L300 только в размерах предметного стола и, как следствие, в возможности проводить инспекцию пластин большей площади.
Применение:
- Антенны
- Телекоммуникации и электроника
- Полупроводниковые пластины
- Мобильные телефоны, бритвы и часы
| Корпус | Встроенная эпископическая подсветка; встроенные источники питания для моторизованного управления; моторизованное управление револьвером; регулировка интенсивности света; управление апертурной диафрагмой |
| Механизм фокусировки | Поперечный ход: 29 мм; Грубая фокусировка: 12,7 мм/об. (регулировка усилия, имеется механизм рефокусировки); Точная фокусировка: 0,1 мм/об. (шаг 1 мкм). |
| Эпископический осветитель | Встроенный источник света галогенной лампы 12В / 100Вт; моторизованная апертурная диафрагма (центрируемая); диафрагма фиксированного поля (с фокусирующей мишенью); может быть установлен ползунок с отверстиями (опция); можно установить четыре 25-миллиметровых фильтра (NCB11 / ND4 / ND16 / GIF); поляризатор; анализатор |
| Револьвер | Шестиместный универсальный револьвер с фиксированным приводом; предусмотрен слот для крепления ДИК |
| Окулярные тубусы | L2TT - Сверхширокоугольный тринокулярный окуляр (угол наклона 0-30 °, прямое изображение); F.O.V .: 25 мм; переключение оптического пути: 2-стороннее (бинокль: фото 100: 0/0: 100) |
| Предметные столики | Предметный столик 8 х 8; ход: 205 х 205 мм; возможно переключение грубого / точного движения; фиксированные элементы управления точным перемещением по осям X и Y |
| Окуляры | Серия линз окуляра CFI |
| Объективы | CFI60 LU / L Plan серии |
| Вес | 43,75 кг (96,45 фунта) при использовании столика 8 x 8 и окулярной трубки L2TT |
| Стандарт: | SEMI S2-93A, S8-95, CE, UL |
- Скачать брошюру
В основе почти каждого электронного продукта лежат тонкие полупроводниковые пластины, на которых создаются микросхемы за счет диффузии и осаждения различных веществ. Индустрия микроэлектроники, представляющая одну из самых сложных областей современной технологии, существовала в соответствии с историческими принципами, согласно которым каждое поколение микросхем должно быть тоньше, эффективнее и дешевле.
Сегодня производители пластин также сталкиваются с повышенным давлением со стороны потребителей, чтобы они быстрее выводили свои новейшие продукты на рынок. В то время как предыдущие поколения микрочипов выпускались каждые два или четыре года, сегодняшний оборот исчисляется месяцами, и многие клиенты ожидают появления новых продуктов каждый год. Хотя переход к устройствам нанометровых размеров может помочь снизить стоимость каждой функции каждого устройства, требования к конструкции этих высокопроизводительных чипов также создают новые технические проблемы для метрологии, используемой при их производстве и контроле.
В этом трудоёмком процессе даже малейшее отклонение может иметь значительные последствия для последующей обработки, что может привести к потерям, исчисляемым миллионами долларов. Производители в этой отрасли должны всегда внимательно следить за производственными дефектами на краях пластины, а также за возможными дефектами субмикронного масштаба, такими как загрязняющие частицы, открытые линии и короткие замыкания между линиями. Чтобы добиться этого, отделы контроля полагаются на изображения в проходящем и отраженном свете (с использованием белого света или лазеров) для выявления поверхностных дефектов на ранней стадии производственного процесса, чтобы можно было быстро принять меры по исправлению положения.


















































































